파괴 검사
Package Decapsulation
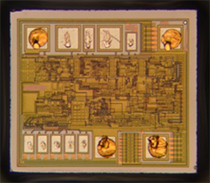 Full Decap
Full Decap
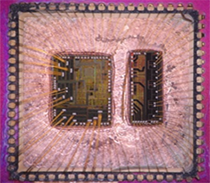 Stitch Decap
Stitch Decap
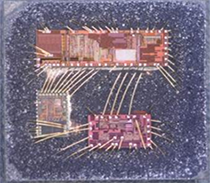 MCP Decap
MCP Decap
 Power IC Decap
Power IC Decap
전자 부품은 내부의 chip을 보호하기 위해 EMC(epoxy molding compound)라고 불리는 합성 봉지제로 둘러 싸여 있습니다.
내부의 chip 혹은 gold wire, lead frame을 관찰하기 위해 합성 봉지제를 제거 하는 과정을 Decapsulation이라 명칭 합니다.
Decapsulation은 크게 EMC의 일부분을 선택적으로 제거하는 Hole Decapsulation과 EMC 전부를 제가하는 Full Decapsulation으로 구분되며, Hole Decapsulation의 경우 내부의 Wire 및 Bonding Pad에 Damage없이 EMC를 제거하는 공정이므로 추가적인 전기적측정이 가능하다는 장점을 가지고 있습니다. 또한 EMC뿐만 아니라 Glass 재질이나, 특수 Resin, 금속 재질의 Device에 대한 Decapsulationeh 서비스 되고 있습니다.
파괴 검사
Chip Delayering
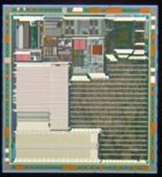 Metal-4
Metal-4
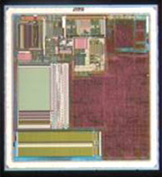 Metal-3
Metal-3
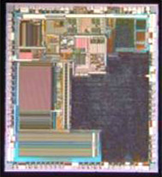 Metal-2
Metal-2
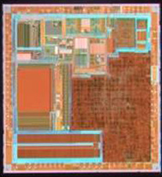 Metal-1
Metal-1
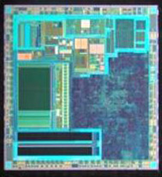 Poly
Poly
반도체는 여러 층의 금속 층과 산화막으로 구성되어 있습니다. 반도체 내부의 구조 및 분석을 위해 각 층을 하나씩 제거하여야 할 경우 De-layering을 실시하게 됩니다. Chip의 불량은 표면이나 그 Under Layer에 존재하기도 하므로 각 Layer를 Layer별 제거하면서 관측하여야 한다. 각 Layer를 제거하는 방법은 화학약품(Chemical)을 사용한 습식 식각(WET Etch)이나 Gas를 사용한 건식 식각(DRY Etch) 이 있으며 건식 식각에는 RIE(Reactive Ion Etching) 분석장비를 사용한다.
파괴 검사
Cross-section & Micro Polishing
 QFN 단면
QFN 단면
 TSOP Lead 단면
TSOP Lead 단면
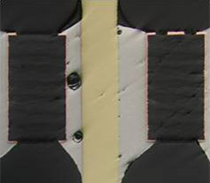 PCB Dip Bia-hole 단면
PCB Dip Bia-hole 단면
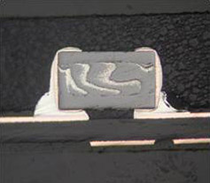 Capacitor 단면
Capacitor 단면
전자 부품은 내부의 chip을 보호하기 위해 EMC(epoxy molding compound)라고 불리는 합성 봉지제로 둘러 싸여 있습니다.
내부의 chip 혹은 gold wire, lead frame을 관찰하기 위해 합성 봉지제를 제거 하는 과정을 Decapsulation이라 명칭 합니다.
Decapsulation은 크게 EMC의 일부분을 선택적으로 제거하는 Hole Decapsulation과 EMC 전부를 제가하는 Full Decapsulation으로 구분되며, Hole Decapsulation의 경우 내부의 Wire 및 Bonding Pad에 Damage없이 EMC를 제거하는 공정이므로 추가적인 전기적측정이 가능하다는 장점을 가지고 있습니다. 또한 EMC뿐만 아니라 Glass 재질이나, 특수 Resin, 금속 재질의 Device에 대한 Decapsulationeh 서비스 되고 있습니다.
파괴 검사
Dye & Pry
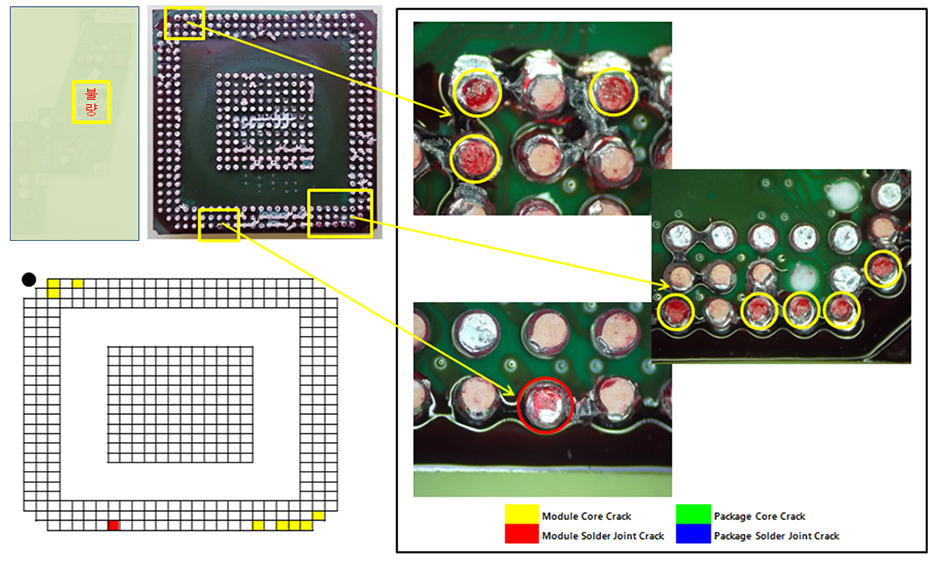
전자부품과 printed circuit board간의 접합 부위에 염료를 침투시켜 접합 부위에 결함 유무 및 위치, 크기를 확인할 수 있는 분석 기법입니다.
Solder joint crack / Open 유무 확인 가능합니다.

