수명시험
고온/고속수명 시험
(High Temperature/High Speed Operation Life)


기존 HTOL은 10MHz 이하 동작주파수 범위 내에서 적용하여 시험을 진행하였으나 현재는 200MHz 이상의 동작주파수를 필요로 하는 IC들이 지속적으로 개발되고 제품에 적용되고 있는 현실이다. 가속수명시험 장비의 한계점(Max. 10Mhz)을 자체 개발된 High speed board System의 기술을 적용 실제 구동 환경과 가까운 300MHz급 HTOL 시험을 목적으로 하고 있다.
수명시험
고온동작수명 시험
(High Temperature Operation Life)
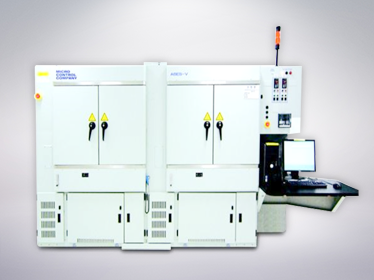

이 시험은 디바이스를 대상으로 bias와 온도조건이 시간에 따라 어떤 영향을 주는지 평가하는 시험이다. 또한 디바이스의 동작상태를 가속방법으로 simulation하는 것으로서, 디바이스 인증이나 신뢰성 모니터링 등에 사용됩니다.
| Stress | Ref. | Abbv. | Conditions |
|---|---|---|---|
| High Temperature Operating Life | JESD22-A108. JESD85 |
HTOL | TJ ≥ 125°C Vcc ≥ Vcc max |
수명시험
저온동작수명 시험
(Low Temperature Operation Life)

저온에서 장시간 동작할 때 어떤 신뢰성을 보이는지 평가하는 시험이다.
시료에 규정된 bias를 인가 하고 규정된 온도(저온)에서 장시간 시험한다.
LTOL의 개념은 기본적으로 HOTL과 동일하며, 이 시험에서 나타나는 주요불량은 미세회로 공정으로 인한 트랜지스터의 채널 축소로 인한 Hot carrier 현상에 기인된 불량을 관찰하기 위함이다.
| Stress | Ref. | Abbv. | Conditions |
|---|---|---|---|
| Low Temperature Operating Life | JESD22-A108 | LTOL | TJ ≤ 50 °C Vcc ≥ Vcc max |
수명시험
초기수명불량 시험
(Early Life Failure Rate)
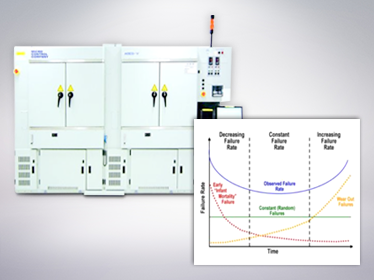
반도체부품 불량에 대한 시간분포는 일반적으로, 그림과 같은 “욕조(bathtub)” 곡선으로 표현됩니다. 이 곡선은 서로 다른 세가지 요소로 구성되는데, 급격히 감소하는 “infant mortality”와 안정적이고 실용적인 수명부분 (즉, 불량률이 계속 감소하거나 아주 일정한 부분), 그리고 마모(wear-out)특성을 나타내면서 불량률이 증가하는 구간으로 나뉩니다. Infant mortality와 실용적 수명기간의 불량은 보통 제조공정상 결함으로 유발되며, 이런 결함의 대부분은 효과적인 신뢰성 screen 작업으로 제거할 수 있습니다.
| Stress | Ref. | Abbv. | Conditions |
|---|---|---|---|
| Early Life Failure Rate | JESD22-A108. JESD74 |
ELFR | TJ ≥ 125 °C Vcc ≥ Vcc max |

